在人工智能技术的快速发展背景下,半导体先进封装技术正逐渐从幕后走到台前,成为AI芯片制造领域的焦点。这项技术通过集成不同功能、制程、尺寸和厂商的芯粒,以灵活、高效且经济的方式打造系统级芯片,赢得了众多AI芯片厂商的青睐。
作为全球半导体行业的领军企业,英特尔自上世纪70年代起便致力于封装技术的创新,积累了深厚的经验。面对AI时代的挑战,英特尔正携手生态系统伙伴和基板供应商,共同制定标准,推动先进封装技术在整个行业的应用。秉承“系统工艺协同优化”的理念,英特尔代工服务不仅提供传统的封装、互连和基板技术,还涵盖了系统级架构与设计服务,以及热管理和功耗管理等全方位支持。
英特尔代工的先进系统封装及测试技术组合丰富多样,包括FCBGA 2D、FCBGA 2D+、EMIB 2.5D、EMIB 3.5D、Foveros 2.5D & 3D以及Foveros Direct 3D等技术。这些技术各具特色,能够满足不同场景下的需求。

FCBGA 2D技术适用于成本敏感、I/O数量较少的产品;FCBGA 2D+则通过增加基板层叠技术,减少了高密度互连的面积,降低了成本,特别适用于网络和交换设备等产品。EMIB 2.5D技术通过微型硅桥连接芯片,适用于高密度的芯片间连接,在AI和高性能计算领域展现出卓越性能。而EMIB 3.5D则引入了3D堆叠技术,增加了堆叠的灵活性,能够根据IP特性选择垂直或水平堆叠,避免了大型中介层的使用。
Foveros 2.5D和3D技术则采用焊料连接方式,适合高速I/O与较小芯片组分离的设计;Foveros Direct 3D技术则通过铜和铜直接键合,实现了更高的互连带宽和更低的功耗,提供了卓越的性能。这些技术并非相互排斥,而是可以在一个封装中同时使用,为复杂芯片的设计提供了极大的灵活性。
针对AI芯片的封装需求,EMIB 2.5D技术相较于其他晶圆级2.5D技术具有显著优势。首先,在成本效益方面,EMIB技术采用的硅桥尺寸小,制造时能更高效地利用晶圆面积,减少了空间和资源的浪费,降低了综合成本。其次,在良率提升方面,EMIB技术省略了晶圆级封装步骤,减少了复杂工艺带来的良率损失风险,提高了整体生产过程的良率。

在生产效率方面,EMIB技术的制造步骤更少、复杂度更低,生产周期更短,能够为客户节省时间。在市场动态快速变化的情况下,这种时间优势有助于客户更快地获得产品验证数据,加速产品上市。在尺寸优化方面,EMIB技术将硅桥嵌入基板,提高了基板面积的利用率,能够在单个封装中集成更多芯片,容纳更多工作负载。最后,在供应链与产能方面,英特尔拥有成熟的供应链和充足的产能,确保了EMIB技术能够满足客户对先进封装解决方案的需求。
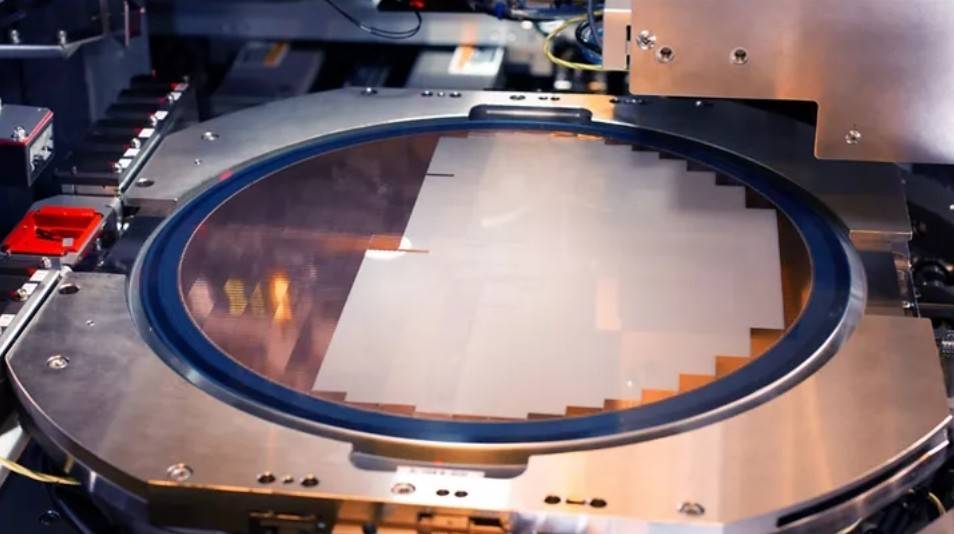
英特尔在先进封装技术领域的不断创新,不仅推动了AI芯片制造的发展,也为全球半导体产业注入了新的活力。随着技术的不断进步和应用场景的拓展,英特尔将继续引领和推动先进封装技术的发展,为行业带来更多的创新和突破。









